Hollow Cathode
-
Hollow Cathode Plasma Source- Hollow Cathode Plasma Source는 Hollow cathode(cathode의 hole)를 통해 플라즈마를 발생시키는 Remote 플라즈마 소스로, 기존 CCP나 ICP 플라즈마 소스에
비해 더 높은 Plasma density 와 더 낮은 Plasma damage를 구현하며, Oxygen contamination이 거의 없는 특징을 가지고 있고, ALD, ALE, 그리고 CVD system에 효과적으로 사용될 수 있습니다. -
RF Hollow Cathode 플라즈마 소스의 특징- Custom solutions from Meaglow Ltd.
- ALD and MOCVD conversions
- Scalable plasma source (more holes = greater area)
- High electron density (>1x1012cm-3)
- Low oxygen contamination for nitride processes
- Less plasma damage than ICP
- Quick on/off
- Higher growth rates and better crystallinity than ICP for many processes
- Nitrogen, hydrogen, ammonia, nitrous oxide, oxygen, argon all trialled to date.
SERIES 50

- NW50 vacuum flange 에 연결됨
- ALD, Oxidation 및 PECVD에 적용
- 최대 8” wafer까지 적용 가능
● Series 50 Hollow Cathode Plasma Source 사양
• NW50 (KF50) vacuum connection.
• NW50 (KF50) nipple housing on request.
• 300 or 600 Watt maximum applied power.
• DC or 13.56 MHz RF operation.
• N, HN or DIN input voltage connectors, others on request.
• Male or female VCR gas input.
• Water cooling, 1-3 liters/min room temperature water (distilled or deionized preferable). Swagelok connections.
• Integrated matching box on request.
• 316 stainless is standard, but other cathode materials on request.
• Operation from 100 mTorr to > 10 Torr.
• Gases to date: NH3, N2, H2, Ar, O, NO, others possible depending on material compatibility.
• RF generator, matching network and matching network controller supplied on request. Will advise for modification of existing equipment.
-
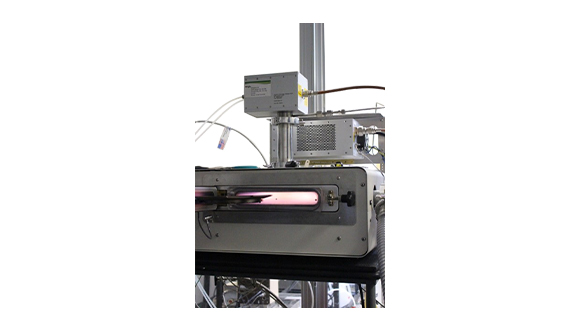
8인치 wafer 위에 TiN film ALD 증착 공정에서 기존의 ICP 대신에
Series 50 Hollow cathode 플라즈마를 사용했을 떄의 결과(resistivity, GPC) 변화
ICP source: 1365 μΩ.cm, 0.94 A/cycle
Hollow cathord source: 330 μΩ.cm, 1.14 A/cycle -
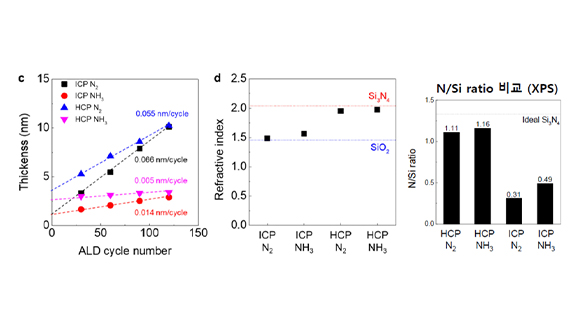
Si3N4 film ALD 증착 공정에서 기존의 ICP 대신에 Series 50 Hollow cathode
플라즈마를 사용했을 떄의 결과(GPC, RI, 및 N/Si ratio) 변화 -
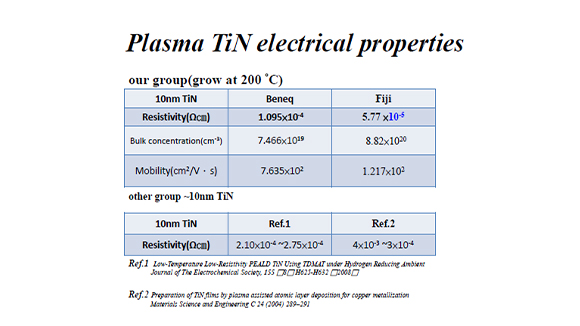
CCP를 적용한 Beneq system 과 Hollow Cathode 플라즈마를
적용한 Fiji system의 결과 비교
Hollow Cathode 플라즈마 소스가 CCP에 비해 Film conductivity 측면에서
더 좋은 결과를 나타내고 있음. -

-

UHV SERIES

- 3 and 3/8” 또는 4 and 5/8” conflat vacuum flange에 연결됨
- 최대 8” wafer까지 적용 가능
● UHV series Hollow Cathode Plasma Source 사양
• Conflat fittings, sizing on request 3 and 3/8” and 4 and 5/8” most common.
• Nipple housing on request.
• 300 or 600 Watt maximum applied power.
• DC or 13.56 MHz RF operation.
• N, HN or DIN input voltage connectors, others on request.
• Male or female VCR gas input.
• Water cooling, 1-3 liters/min room temperature water (distilled or deionized preferable). Swagelok connections.
• Integrated matching box on request.
• 316 stainless is standard, but other cathode materials on request.
• Operation from 100 mTorr to >10 Torr.
• Gases to date: NH3, N2, H2, Ar, O, NO, others possible depending on material compatibility.
• RF generator, matching network and matching network controller supplied on request. Will advise for modification of existing equipment.
-

TiN film ALD 증착 공정에서 기존의 ICP 대신에 UHV series Hollow cathode
플라즈마를 사용했을 떄의 결과(resistivity) 변화
ICP source (15nm) : 970 μΩ.cm
ECS Journal of Solid State Science and Technology, 3 (2014) P253
ICP source (20 nm) : 145 μΩ.cm
J. Vac. Sci. Technol. A 32 (2014) 031506
HCP source: 57 μΩ.cm -

LARGE AREA

- 12” wafer 에 적용
● LARGE area Hollow Cathode Plasma Source 사양
• Conversion of commercial and home built ALD systems.
• 300 and 600 watt systems , higher power on demand, a 3 kilowatt , 12” source
• 12” wafer diameter, plus larger on request.
• 300 watt systems may not require water cooling
• Oxides, nitrides, other
• Low oxygen contamination (no dielectrics)
• Cost effective
• High electron density – similar to or greater than inductively coupled and microwave plasma sources, up to 1013 cm-3 for some plasma conditions.
• Wide range of operating pressures (eg. from <50 mTorr to >5 Torr).
• Improved growth per cycle for many material systems
-

12inch diameter Hollow Cathode, 3000 W operation
Series 16

- NW16 vacuum flange 에 연결됨
- 최대 4” wafer까지 적용 가능
● Series 16 Hollow Cathode Plasma Source 사양
• Max. 80 watt operation continuously, up to 100 watt in pulse mode.
• No water cooling. The system can get hot and present a heat hazard, air cooling can moderate this.
• Suitable for 2 to 4” wafers and smaller test samples.
• Oxides, nitrides, other
• Low oxygen contamination (no dielectrics)
• Cost effective
• High electron density of 1012 cm-3 or higher dependent on conditions.
• Wide range of operating pressures (eg. from < 200 mTorr to > 10 Torr).
• Improved growth per cycle for many material systems




