엘립소미터
-
Thin Film 두께 측정 (Multi-Wavelength Ellipsometer)4개 또는 6개의 파장을 사용함.
Single-wavelength(단파장) 엘립소미터와 비슷한 저렴한 가격으로 SE(spectroscopic ellipsometer)의 성능을 가지고 있음
Ex-situ 또는 In-situ 방식으로 conversion 용이함.
박막 증착 장비에 탑재하여 In-situ 방식으로 공정 실시간 박막 두께 측정 가능
LED 광원 사용(5만 시간 이상 사용 가능) → 램프 교체 필요 없음.
Detector가 고정되어 있음 → 빠른 측정 가능(10ms), 부품교체 없이 장기간 사용 가능
탁월한 측정 재현성(precision) : 최고 0.001nm 수준
Analysis(분석) 프로그램이 시스템에 내장되어 있기 때문에, 별도의 프로그램 설치가 필요 없음
Wafer mapping system (추가적인 기능)
Multi-Wavelength Ellipsometers

- FS-1 ™
- FS-1EX ™
● FS-1™
- 4개의 파장 사용 : Blue(450nm), Green(525nm), Yellow(595nm), Red(660nm)
- 0~1µm 박막 두께 측정 가능. 투명한 박막의 경우 0~2µm 두께 측정 가능
- 65° 입사각, 샘플 크기는 최대 200mm diameter 및 23mm 두께까지 가능
- 샘플 위의 Beam size : 5x12mm
- Compact footprint (180 x 400mm) 및 가벼운 무게 (4.8 kg)
● FS-1EX
- 6개의 파장 사용 : 405~950 nm
- 0~3µm 박막 두께 측정 가능. 투명한 박막의 경우 0~5µm 두께 측정 가능
- 65° 입사각, 샘플 크기는 최대 200mm diameter 및 23mm 두께까지 가능
- 샘플 위의 Beam size : 5x12mm
- Compact footprint (180 x 400mm) 및 가벼운 무게 (4.8 kg)
< 적용 분야 >
- 반도체 분야: silicon oxide and nitrides, high and low k dielectrics, amorphous, and polycrystalline silicon films, photoresists
- 광학 코팅 분야: high and low index films such as SiO2, TiO2, Ta2O5, MgF2, etc.
- 디스플레이 분야: TCO’s (such as ITO), amorphous silicon films, organic films (for OLED technology)
- 데이터 저장 장치 분야: diamond like carbon films
- R&D 공정 분야: in situ characterization of film deposition(rate and optical constants) vs. process conditions, applicable to MBE, MOCVD, ALD, Sputtering, etc.
- 화학 및 생물학 분야: detection of sub-monolayer material adsorption in liquid cell experiments
- 공학 분야: in-line monitoring and control of film thickness

Automated Mapping Systems
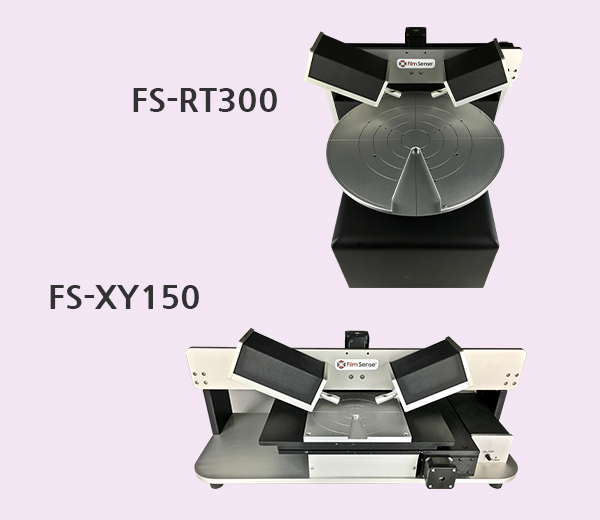
- FS-RT300
- FS-XY150
● 6개의 파장 사용 : 405~950 nm
● 0~3µm 박막 두께 측정 가능, 투명한 박막의 경우 0~5µm 두께 측정 가능
● 샘플 위의 Beam size : 0.8x1.9mm (다른 Beam size도 가능함)
● 샘플 자동 alignment 를 위한 전동식(motorized) Z-stage
● Mapping 측정 Point 패턴 조절 가능
FS-RT300
- Typical time for wafer map : 90 seconds (49 points on a 300 mm diameter wafer)
- Compact footprint : 400x500 mm, 22 kg
- Stage travel: R (linear) 150mm, resolution: 12µm, Thera(rotation) 360°, resolution: 0.1
FS-XY150
- Typical time for wafer map : 60 seconds (49 points on a 150 mm diameter wafer)
- Compact footprint : 600x600 mm, 16 kg
- Stage travel (X,Y) : 150 x 150mm, resolution: 5µm
In Situ Monitoring

- FS-1EX Mounted on Kurt Lesker ALD Chamber
- FS-1 Mounted on AJA Sputter Chamber
● Sub-monolayer thickness precision
● Window port가 있는 챔버에 부착가능. (표준 2.75" 또는 1.33" conflat flange 사용)
● 다양한 공정 조건에서 실시간 박막 광학 상수(n&k) 및 증착률 측정 가능
● 다층 박막 증착의 모니터링과 조정 가능
● 외부 소프트웨어와 연결하여 조정 가능 (LabVIEWTM compatible)
● 대부분의 박막 증착 기술에 적용 가능함(Sputtering, ALD, MBE, MOCVD, e beam evaporation 등